
Reliability Tests
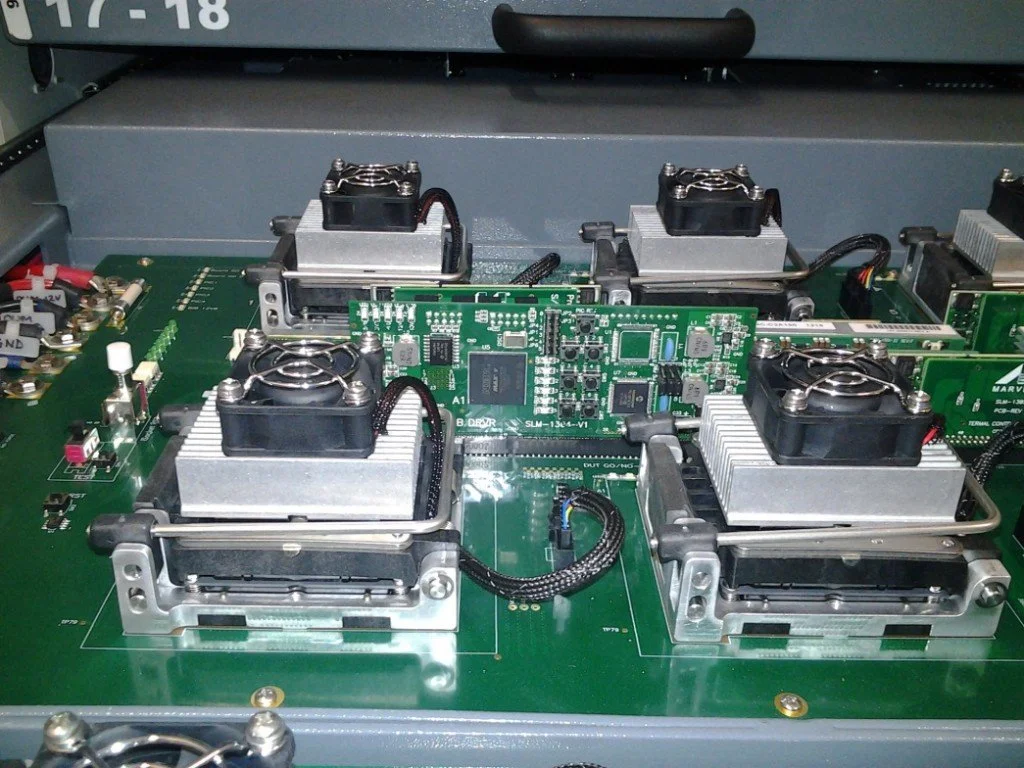
HTOL (HIGHT TEMPERATURE OPERATING LIFE)
This test is used to determine the effects of bias conditions and temperature on solid-state devices over time. Simulates the operating status of devices in an accelerated manner.
LTOL (LOW TEMPERATURE OPERATING LIFE)
It is a reliability test similar to HTOL, but instead of applying high temperature, low temperature (e.g. -40°C or -55°C) is applied while the device is electrically operating.


ELFR (EARLY LIFE FAILURE RATE OF INTEGRATED CIRCUITS)
This test provides failure characteristics early in the life of new or untested technologies when generic data is not available.
RF HTOL (HIGH TEMPERATURE LIFE AT RADIO FREQUENCY)
This test is used to determine the effects of RF bias conditions and temperature on power amplifier modules (PAMs), switches, transceivers, tuners, and other RF components over time. Simulates the operating status of devices in an accelerated manner.
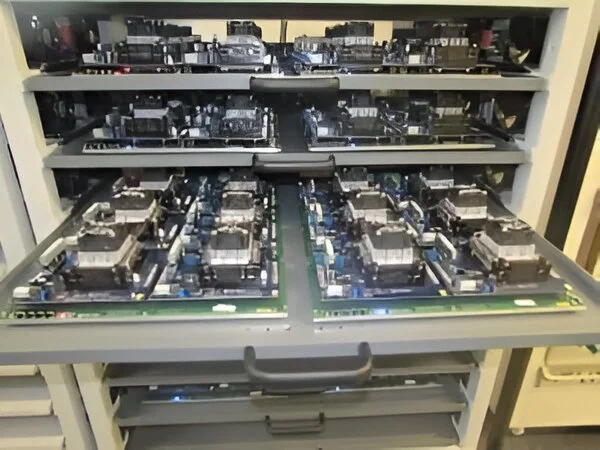

PTC (TEMPERATURE AND POWER CYCLES)
This test is performed to determine the ability of a device to withstand alternating exposures to extreme high and low temperatures with operational biases periodically applied and removed.
THB (TEMPERATURE AND HUMIDITY BIAS TEST)
This standard establishes a method and defined conditions for performing a temperature and humidity shelf life test with applied bias.


HAST (HIGHLY ACCELERATED STRESS TEST)
The purpose of this test method is to evaluate the reliability of non-hermetically packaged solid state devices in humid environments.

Request Your Quote Today
Ensure the reliability and performance of your electronic components with our professional Semiconductor services.
We provide the insights you need to make informed decisions and prevent costly failures.
Fast Response – Get your evaluation started within 24 hours.
Accurate Results – Backed by state-of-the-art equipment and certified experts.
Custom Solutions – Tailored to your industry and product requirements.


